前回の記事では、高屈折率の液体を用いることで臨界角を大きくし、液浸露光装置における光の収集効率が向上する様子を説明しました。
今回は、以下の特許明細書を参考に、「開口数」「解像度」「焦点深度」がどのように微細化に寄与するのかを説明します。
特許明細書
WO2007088862A1「高開口数露光装置用ペリクル」(三井化学株式会社)
[0007] 回路パターンの微細化には、上記のように露光光の波長を短波長する他に、露光装置の投影レンズの開口数を大きくする方法がある。
[0008] 光学顕微鏡の分解能を向上させる技術として、観察対象と顕微鏡の対物レンズとの間に高屈折率の液体を満たす液浸技術は古くから知られていた。特開平 7-220990や特開平 10-303114等に開示されているように、半導体リソグラフィにおいても漸く液浸露光技術を用いた装置が開発されるようになってきた。
[0009] 液浸露光技術を用いることで、露光装置の光学系の開口数を大きくすることが可能になり、回路パターンの解像度を上げることができる。開口数 NA (Numerical Aperture )は、下式
NA = n X sin θ
で定義される。式中、 nは露光光が透過する媒体の屈折率であり、 θは露光光の最大入射角度である。ここで入射角は、入射点に立てた法線となす角度を指す。すなわち、入射面に対して光が垂直に入射する場合が入射角 0° であり、入射面に平行に近い場合は入射角は 90°に近い値をとる。[0010] 空気の屈折率は1なので大気中で露光する限り開口数は 1以下の値をとるが、半導体ウェハと露光装置の投影レンズとの間の空間を屈折率の高い液体で満たすことで 1以上の開口数を実現出来る。
[0011] 大気中で露光する従来の露光装置としては開口数 0. 84のステツパが広く用いられ ているが、液浸露光技術を用いた露光装置としては開口数 1. 07の液浸ステツパが 市販され始めようとしており、更に開口数 1. 2程度の液浸ステツバが開発されている。
開口数NAと液浸露光の関係
引用元の特許明細書では、液浸露光技術が開口数を大きくする方法として具体的に説明されています。
[0009] 液浸露光技術を用いることで、露光装置の光学系の開口数を大きくすることが可能になり、回路パターンの解像度を上げることができる。開口数 NA (Numerical Aperture )は、下式NA = n X sin θで定義される。式中、 nは露光光が透過する媒体の屈折率であり、 θは露光光の最大入射角度である。ここで入射角は、入射点に立てた法線となす角度を指す。すなわち、入射面に対して光が垂直に入射する場合が入射角 0° であり、入射面に平行に近い場合は入射角は 90°に近い値をとる。
[0010] 空気の屈折率は1なので大気中で露光する限り開口数は 1以下の値をとるが、半導体ウェハと露光装置の投影レンズとの間の空間を屈折率の高い液体で満たすことで 1以上の開口数を実現出来る。
ここで登場する開口数NAとは、レンズが光をどれだけ効率良く集光するかを示す指標です。開口数NAを大きくするには、以下の2つの方法が考えられます。
- 媒質の屈折率nを高める 例: 空気 (屈折率 ≒ 1) を水 (屈折率 ≒ 1.44) に置き換える。
- sinθを大きくする 例:液浸露光により光の臨界角を拡大する。
なお、開口数における角度θは、光がレンズ内で形成する最大の角度を指します。これは単純な物質表面での入射角とは異なり、レンズ材料(媒質)の屈折率だけでなく、レンズの形状や光学設計にも依存します。
このように液浸露光では、媒質の屈折率を高めることで NA>1 を実現可能です。
解像度の向上
[0009]…回路パターンの解像度を上げることができる。…
ここでいう解像度Rとは何でしょうか。
解像度Rは、露光装置がどれだけ微細なパターンを描けるかを示す指標です。解像度を決定する主な要因は、レイリーの公式で表されます。

ここで:
R: 解像度(線幅)
k1:プロセス因子(露光技術の効率を示す定数)
λ: 使用する光の波長
NA: レンズの数値開口(Numerical Aperture)
開口数NAを大きくすることで、解像度Rを小さくし、より微細なパターンが形成可能になります。
乾式vs液浸リソグラフィの解像度比較
[0011] 大気中で露光する従来の露光装置としては開口数 0. 84のステツパが広く用いられ ているが、液浸露光技術を用いた露光装置としては開口数 1. 07の液浸ステツパが 市販され始めようとしており、更に開口数 1. 2程度の液浸ステッバが開発されている。
波長 193nm における屈折率nは、空気中で≒1.00、純水では≒1.44です。
これにより
乾式リソグラフィでは、NA空気=1.0・sin(41°)≒0.84、
液浸リソグラフィでは、NA純水=1.44・sin(73°)≒1.07
が実現されます。
波長193nmでは、液浸リソグラフィが乾式リソグラフィより高い解像度解像度を示します。
補足:ステッパとは
ステッパとは、ウエハの小区画ごとに露光を行う装置です。静止状態のマスク全体を用いて露光を終えると次の区画に移動して同様の操作を繰り返します。
ただし現在では、マスクパターンの一部を使用し、細長い照射領域をウエハ上で移動させながら露光するスキャナに主流が移行しています。
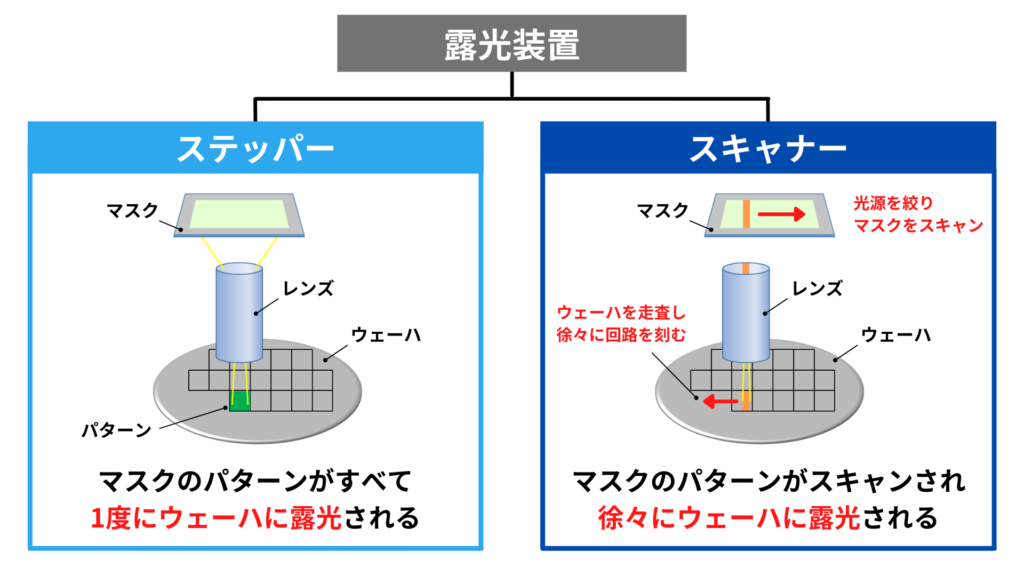
解像度と焦点深度のトレードオフ
このまま開口数を高め、高解像度を実現すると順調に微細化が進みそうに思えますがある問題が顕在化します。それが焦点深度という光学系の性質です。
焦点深度とは?
焦点深度(Depth of Focus, DOF)とは、光学系が正確にピントを合わせられる範囲のことで、以下の式で表せます。

ここで:
k2:プロセス因子
λ:使用する光の波長
NA:開口数
焦点深度は、開口数NAの逆二乗に反比例するため、開口数が高くなると、焦点深度は急激に浅くなります。
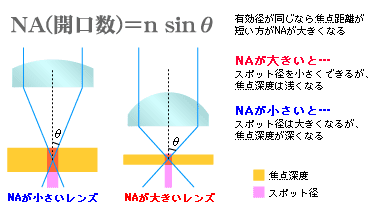
焦点深度が浅くなる影響
露光装置では、この焦点深度内にウエハ表面が位置することで高精度な露光が可能です。しかし焦点深度が浅くなると、以下のような課題が生じます。
- ウエハ表面の平坦度への厳しい要求:ナノメートル単位での制御が必要になります。
- 露光装置の位置制御精度への高い要求:位置のわずかなずれが許容されなくなります。
- 歩留まりの低下:ピントのズレによる露光不良が発生しやすくなります。
液浸露光による焦点深度の緩和
液浸露光の場合、焦点深度が浅くなる影響が若干緩和されます。
乾式リソグラフィの制約
乾式リソグラフィでは、短波長光を光源に直接利用するため、
- 分子の波長λが短くなるほど焦点深度が浅くなります。
- 媒質の屈折率n≒1に固定されるため、開口数NAはNA<1に制約され、焦点深度の浅さを制限する手段が限られます。
液浸リソグラフィの緩和効果
液浸リソグラフィでは、
- 屈折率n>1の媒質を使用するため、開口数NAが増加し、乾式リソグラフィ以上に焦点深度が浅くなる方向に寄与します。
- しかし、波長λが屈折率nに反比例して短縮されるため、波長短縮の影響が緩和され、乾式リソグラフィほど極端に焦点深度が浅くなることを防ぎます。

このため、より短波長の光源を追求するよりも、液浸露光へ切り替えることが焦点深度管理や製造プロセスの安定性を向上させる点で有利です。
液浸露光によるその他のメリット
液浸露光では、高屈折率の媒質(例えば純水など)を利用することで、焦点深度緩和以外にもメリットがあります。
解像度の向上
屈折率 nの増加により、開口数 NA=n⋅sinθ が1を超え、高解像度を達成できます。これにより、微細な回路パターンの形成が可能になります。
収差の低減
屈折率の増加により、開き角 θ を小さく抑えられ、レンズ収差(例: 球面収差)の影響が軽減され、結像性が向上します。
位置制御の精度向上
焦点深度が乾式リソグラフィより浅くなるものの、液浸媒質が光を効率よく制御するため、ウエハ位置のずれに対する影響が緩和されます。
光強度の均一性とエネルギー効率の向上
入射角θを小さく押さえられるため、光の透過率が高くなり、ウエハ乗の光強度が均一になります。その結果、露光プロセスの安定性が向上します。
まとめ
液浸露光は、開口数・解像度・焦点深度のバランスを保ちつつ微細化を実現する技術といえます。
開口数の向上
液浸技術により屈折率を高め、広い範囲の光を収集することで開口数が向上します。
解像度の向上
開口数が向上すると、レイリーの式に基づき解像度が向上します(数値が小さくなります)。
焦点深度の課題
開口数の向上は焦点深度の浅さをもたらしますが、液浸露光によりその影響は緩和。



コメント