今回、この明細書を翻訳しました。
古い特許ですが、平行平板型のプラズマエッチング装置の基本を理解するのに適していると考え選びました。
訳し終えた段階での理解をまとめます。
“Plasma etching apparatus utilizing plasma confinement”
(Lam Research)
本発明は、チャンバ内にエッチングガスを導入、上下の電極間にRF(Radio Frequency)電圧を印加してプラズマを生成します。
課題
プラズマは放って置くと電極間から外側に拡がってしまい、チャンバ壁などへ放電します。プラズマ密度が低下してエッチングの効率性や均一性が損なわれます
手段
ここではプラズマを電極間に閉じ込めるために、複数の誘電体リングを間隔をあけて積層、隙間(スロット)を確保します。スロットの長さを平行自由行程(MFP)より長くして(一実施例だと40倍)、排気される荷電粒子(イオン・電子)がスロットの壁に衝突して中性化されて排出されます。これで望まない放電を防げます。
効果
結果としてプラズマを電極の間に閉じ込めることができ、効率的で均一なエッチングが可能になります。
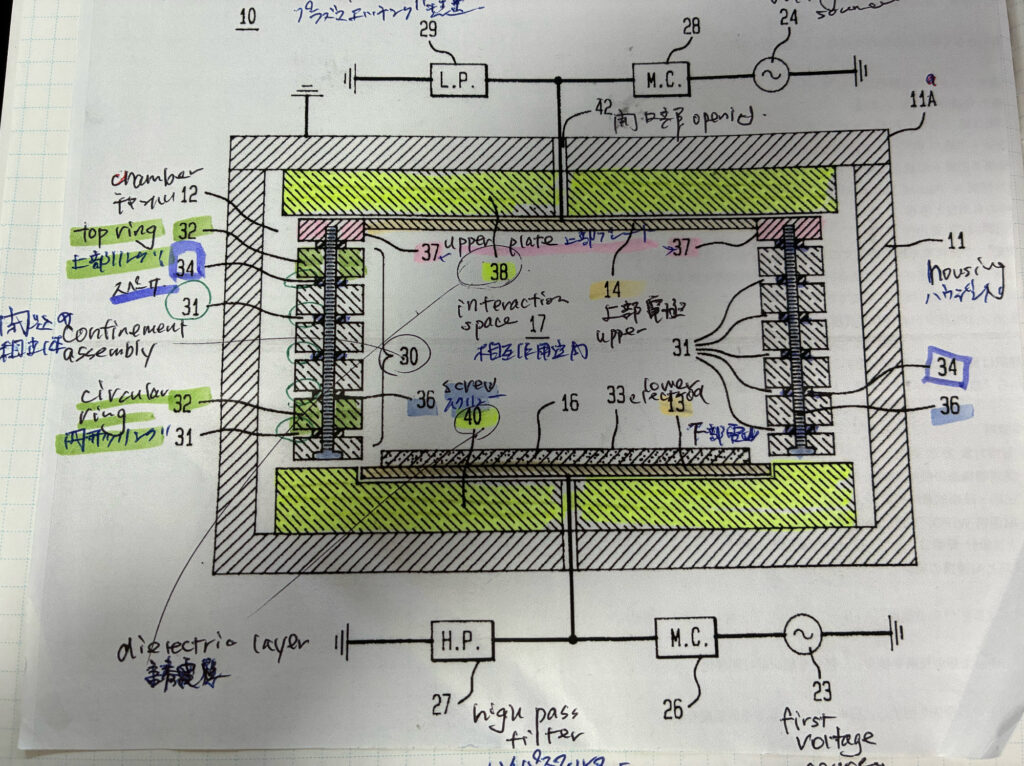



コメント