BEOL工程(Back End Of Line:半導体製造における配線形成工程)において、銅(Cu)配線がアルミニウム(Al)配線に代わって主流となっています。
これは、Cuが低抵抗で微細化に対応しやすいという利点を持つためですが、その一方で、拡散性の高さや電気的信頼性(エレクトロマイグレーション)という課題も抱えています。
今回はこれらの課題に関する明細書をもとに整理します。
公開番号:特開2015-179697
発明の名称:半導体装置の製造方法
出願人:東京エレクトロン株式会社
Cu配線の技術的課題
拡散性の問題とその影響
Cuは電気抵抗が低く導電性に優れている一方で、拡散性が高く、特に高温環境下ではその傾向がより強まります。
Cuが拡散しやすいのは、1)Cuの原子半径が比較的小さいこと、2)高温下で拡散速度が大きいことに起因します。
その結果、層間絶縁膜中にCuが侵入、リーク電流や絶縁破壊など、信頼性の低下を引き起こす恐れがあります。
なおエレクトロマイグレーションの課題は前回のとおりです。
従来のバリア膜技術と課題
こうした拡散を防ぐため、Cu配線ではバリア膜で周囲を覆い、Cuの移動を抑制する技術が用いられてきました。
例えばSiCN(窒化炭化シリコン)やTa/TaN(タンタル/窒化タンタル)などのバリア膜を形成するといった方法です。
さらに、バリア膜とCuとの間の密着性向上のため、CoWP(コバルト-タングステン-リン)などの中間相を挿入する構造も採られてきました。
従来技術の課題
しかし、こうした構造にも以下のような課題がありました。
- 密着性不足:Cuとの密着性が十分でなく、剥離やエレクトロマイグレーションの原因となる
- 選択性の低さ:CoWPが導電性を持ち、絶縁膜上に堆積するとショートするリスクが高まる
- 無電解メッキの工程中、不要な成膜が絶縁膜に生じ、金属コンタミネーションを引き起こす
これらの課題を解決するため、配線部にのみ選択的に成膜されるバリア、の実現が求められていました。
本明細書における解決手段
もう一度ここまでを整理すると
Cu配線の形成においては、デュアルダマシン法により、Cu配線部と絶縁膜が同時に露出するタイミングがあります。このとき、Cuの拡散を防ぐためにバリア膜の形成が不可欠ですが、バリア膜が絶縁膜(SiO₂やSiCNなど)上にも成膜されてしまうという新たな問題がありました。
そこでこの明細書では、Cuだけに成膜ができるよう、Cu表面を酸化(CuOx化)することで、成膜材料との化学反応が起こりやすい状態(活性表面)を作ろうとしたのです。
このCuの表面改質によって、バリア膜がそこに選択的に反応されるように整えたということです。
ALD法による実現
この選択的な成膜は、ALD法(Atomic Layer Deposition:原子層成長)によって実現されます。
ALD法とは、その名の通り原子レベルで材料を堆積させ薄膜形成を制御する技術ですが、成膜対象の表面状態に応じて反応性(成膜速度)が変化するため、このような選択的な成膜を実現するには適当な手法となります。
例えばこの明細書のように、原料ガス(例:マンガン化合物)と酸化剤(例:水蒸気H₂O)を交互に供給し、各反応を自己制御的に進行させながら、原子層単位で成膜を繰り返す方法です。1サイクル毎の反応が終わると自然と停止し(self-limiting)、次の反応サイクルまで不要な堆積は起こりません。このことによって、膜厚を原子レベルで精密に制御可能です。
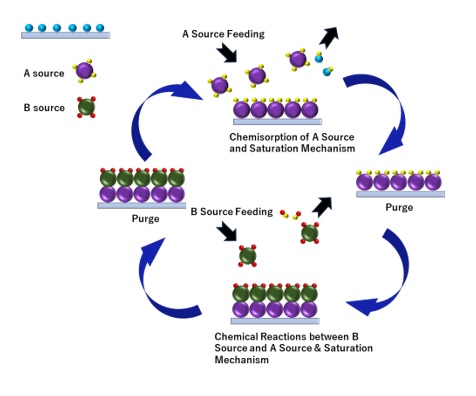
結果として、Cuは低抵抗だけでなく信頼性も向上した配線材料として、選択的な成膜によって余分な工程を削減できます。

出典:
特開2015-179697「半導体装置の製造方法」(東京エレクトロン株式会社)
アイアール技術者教育研究所 ALD(https://engineer-education.com/ald_basic/)


コメント