前回記事より間が空きましたが、自分の理解を書き出すためにエッチング装置をまとめます。
半導体製造装置のつなぎ方
半導体製造には数多くのプロセスがありこの順番は決まっていますが、装置の組み合わせ方には大きく3通りあります。
1つ目は、スタンドアロン装置を、クリーンルーム内でカセット搬送し順に処理する方法です。
例えばクリーンルーム内に成膜装置、エッチング装置、アッシング装置、など装置が独立して配置され、ウェハはカセット搬送で順番に処理されます。
2つ目は、このようなスタンドアロン装置同士を、真空搬送チャンバでつないで一つのクラスターのように使います。
そして3つ目は、最初から一つのフレームに複数のプロセスチャンバを組み込んだマルチチャンバ方式で処理するものです。
クラスター目的
エッチング装置でもクラスター装置が主流です。
マルチチャンバ方式でクラスター化する目的は、大きく2つあります。
1.コンタミ防止
ロードロックから搬送チャンバ、プロセスチャンバへと真空環境内でウェハを搬送することで、大気にさらすことなく清浄な状態で移動させることができます。
2.材料専用化
もう一つは、酸化膜用、ポリシリコン用、金属配線用、など
用途ごとに専用チャンバを分け、チャンバ内のプロセス条件を最適化することです。
材料によって必要となるエッチングガスも異なるため、チャンバを共用すると残留ガスや反応生成物が影響を及ぼす可能性があります。
具体的な装置でイメージする
半導体デバイス装置では、膜を作る(成膜)と膜を削る(エッチング)を繰り返します。
ここでは「削る」を担当するエッチング装置について、考えます。
クラスター型装置の構成要素
先ほどの装置のうち、クラスター型の製造装置は、大きく4つの構成要素で成り立っています。
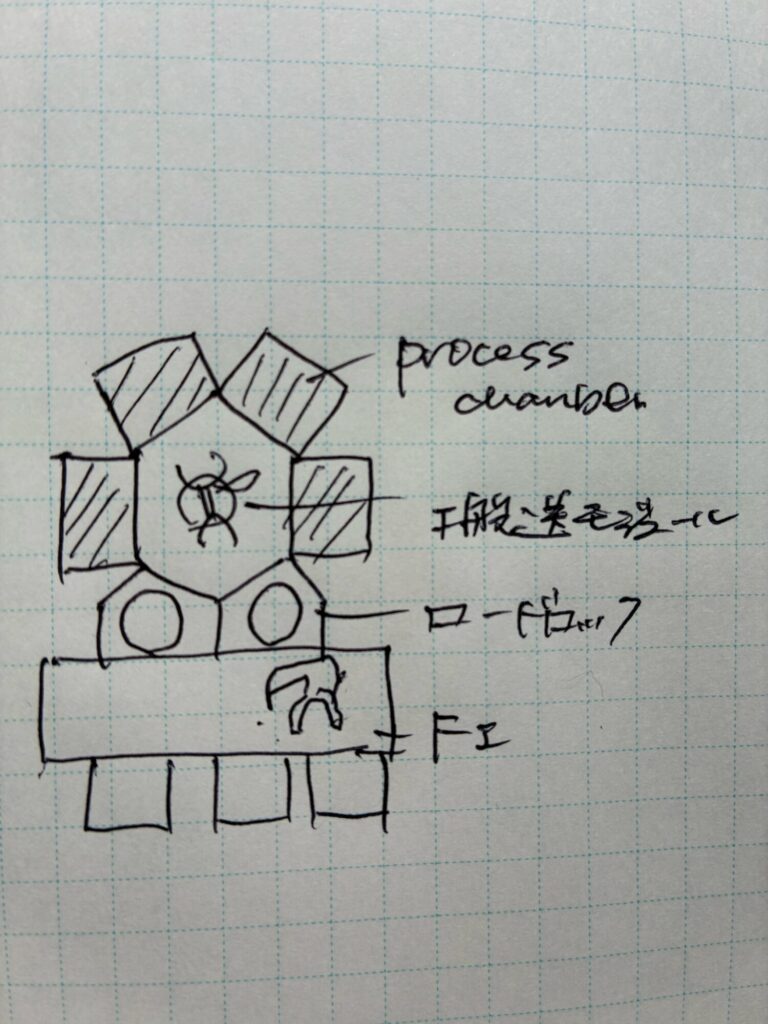
1.FI(ファクトリーインターフェース)
FOUPポートや搬送ロボットがある工場側(大気圧)でウェハを出し入れするローダー/アンローダー。
2.ロードロックモジュール(ロードロックチャンバ)
大気圧領域と真空領域との間に設けられる圧力切替チャンバです。ウェハを搬入・搬出する際に、圧力を大気圧から真空へ、また真空から大気圧へと段階的に切り替えることで、真空を維持します。
3.搬送モジュール(搬送チャンバ)
装置の中央にあって、搬送ロボットでウェハを真空のままチャンバ間を移動させます。
4.プロセスモジュール(プロセスチャンバ)
搬送モジュールを中心に複数配置され、エッチングなどの処理を実際に行うチャンバです。
チャンバの代表例
具体的に材料ごとにチャンバを分けるとはどういうことか、エッチング装置において代表的なチャンバを3つ確認します。
- 酸化膜用プロセスチャンバ
- ポリシリコン用プロセスチャンバ
- 金属配線用プロセスチャンバ
酸化膜用プロセスチャンバ
1つめは、酸化膜用です。
代表的なエッチングガスは、CF4やCHF3などのフッ素系ガスです。
プラズマ中で生成したイオンが物理的にターゲットを削り、Fラジカルが絶縁膜のSiと化学的に反応して揮発性のSiFxとなりエッチングを進めます。またCの成分が側壁にポリマーを形成し、側壁を保護しながら高アスペクト比のエッチングを実現します。
酸化膜をエッチングする場面と言えば、例えば、STI(Shallow Trench Isolation、トランジスタ同士でリークしないよう分離する)の形成や、コンタクトホール形成(形成されたトランジスタと上部の層をつなぎ電気を流すために穴を通す)などです。
ポリシリコン用プロセスチャンバ
2つ目は、ポリシリコン(ドープされた多結晶シリコン)用で、代表的なガスはHBrです。
プラズマ中で生成したイオンによる物理的なエッチングと、Brラジカルがポリシリコン由来のSiと化学反応して揮発性のSiBrxが生成され、材料が除去されます。
一緒にO2が添加されると、側壁にポリマーが形成されて保護になり、酸化膜ほどではないにせよ、異方性のあるエッチングが可能です。
なおポリシリコンのエッチングが必要となるのは、例えばトランジスタのゲート電極(電流を制御するスイッチ部分)を形成するためです。
金属配線用プロセスチャンバ
3つ目は金属配線用です。
エッチングガスとしてはCl₂などの塩素系ガスが用いられ、揮発性の金属塩化物が生成され、除去されます。
例えば、Al配線では全面Alスパッタリングしたのちに、エッチングして配線パターンを形成します。
Cuでは、ドライエッチングの制御が難しいため、ダマシンプロセス(溝を先に掘ってからCuを埋め込む)が主流です(以前記事にまとめました)。
まとめ
エッチング装置は、各モジュールが明確な役割を持って設計されていることが分かります。
FIは工場との接点、ロードロックは圧力の切り替え、搬送チャンバは真空搬送、プロセスチャンバは材料ごとの加工を担います。
構造を理解する際には「何のために存在するか」という機能に着目することで、工程全体の流れが整理しやすくなりました。
参考文献
『はじめての半導体製造装置』(前田和夫著・技術評論社)


コメント