新たな明細書翻訳に取りかかるにあたり、今回は、背景知識の整理から始めます。
アドバイスをいただきありがとうございました。
半導体製造の前工程における中核プロセスであるリソグラフィ(塗布・露光・現像)のうち、「露光」を担う露光装置についてはこれまでも扱ってきました。今回はその中でも最先端技術の象徴といえるEUV露光装置についてまとめます。
EUVとは
電磁波としての位置づけ
EUV(Extreme Ultra Violet:極端紫外)は、波長が13.5nm付近の紫外線で、これは紫外線の中でも波長が短く、電磁波スペクトル上では軟x線に近い高エネルギー領域に位置します。
DUV(Deep Ultra Violet:深紫外)は、おおむね波長300nm以下の紫外線のことを指し、半導体分野での代表例としては193nm、248nmのエキシマレーザー波長域を指します。

エネルギー特性と波長
電磁波は、波長を持つ波であると同時に、運動量を持った光子と呼ばれる粒子でもあります。
光子1個の持つエネルギーは、次の式で表され、波長λとエネルギーEが反比例する関係にあることが分かります(波長が短いほど、エネルギーは高くなります)。
$$ E = h\nu = \frac{hc}{\lambda} $$
ここで、
\( h = 6.626 \times 10^{-34} \ \mathrm{J \cdot s} \):プランク定数
\( \nu \):光の振動数(Hz)
\( c = 3.00 \times 10^8 \ \mathrm{m/s} \):光速
\( \lambda \):波長(m)
エネルギーの単位であるジュール(J)は、力や熱、運動エネルギーなどに用いられる国際単位系(SI)に基づく組立単位です。
実際に、波長 \( \lambda = 13.5 \ \mathrm{nm} = 13.5 \times 10^{-9} \ \mathrm{m} \) のEUV光を代入すると、光子1個のエネルギー \( E \) は次のように求められます:
$$ E = \frac{6.626 \times 10^{-34} \cdot 3.00 \times 10^8}{13.5 \times 10^{-9}} = 1.47 \times 10^{-17} \ \mathrm{J} $$
ただし、ジュール(J)は人間の感覚や原子スケールの現象にはあまりにも小さすぎて扱いにくいため、電子ボルト(eV)という単位がよく使われます。 1 eV は、1個の電子に1ボルトの電圧をかけたときに得られるエネルギーであり、以下のような換算関係があります:
$$ 1 \ \mathrm{eV} = 1.602 \times 10^{-19} \ \mathrm{J} $$
したがって、このエネルギーを電子ボルトに換算すると:
$$ E = \frac{1.47 \times 10^{-17}}{1.602 \times 10^{-19}} \approx 91.9 \ \mathrm{eV} $$
約91.9eVとなります。
可視光の波長帯では、次の図のように、光子1個あたりのエネルギーはおおよそ1.65〜3.26eV程度に収まります(Prangnell, 2020)。

これに対して、13.5nmという波長を持つEUV光の光子エネルギーは約91.9eVですので、可視光との比較からも、非常に高いエネルギーを有することが分かります。
EUV露光装置とは
EUV露光装置とは、レチクルの回路パターンを、EUV光を使って、レジストが塗布されたウエハ上に縮小転写する装置です。
以下は半導体製造工程の概要ですが、露光は、前工程のリソグラフィにおいて、レジスト塗布後、現像前に位置します。
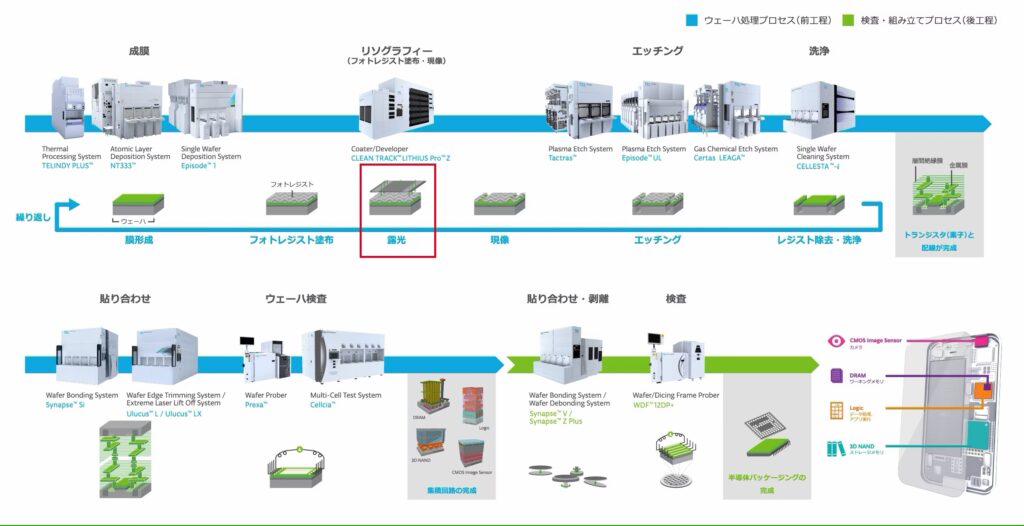
なぜEUV露光装置か
ではなぜEUV露光装置が必要なのでしょう。
スマホやAIの進化に伴い、半導体にはより高性能で、より小さく、より消費電力が低い設計が求められています。そのためには、1枚のチップにできるだけ多くのトランジスタを搭載する=高密度集積化が欠かせません。
このニーズに応える手段には、ウエハの大面積化などもありますが、ウエハサイズには製造装置の制約やコストの問題などの限界があり、より多くのトランジスタを搭載するには、1個あたりの回路サイズを小さくする=「回路パターンをより細かく描く(微細化)」ことが必要となります。
微細化を実現するための手段には、1)光の波長を短くすること、2)開口数(NA:光学素子がどれだけ広い角度から光を集めることができるかを示す指標)を大きくすること(高開口数)があります。
(※なぜ短波長・高開口数によって微細化が実現するか、という点については、以前記載したブログをアップデートする形で後日まとめる予定です。)
1)短波長化のためには、これまでさまざまな波長の光源が採用されてきました。
– 水銀灯を光源とするg線(波長436nm)
– i線(波長365nm)
– DUVのKrF(フッ化クリプトン、波長248nm)、
– ArF(フッ化アルゴン、193nm)
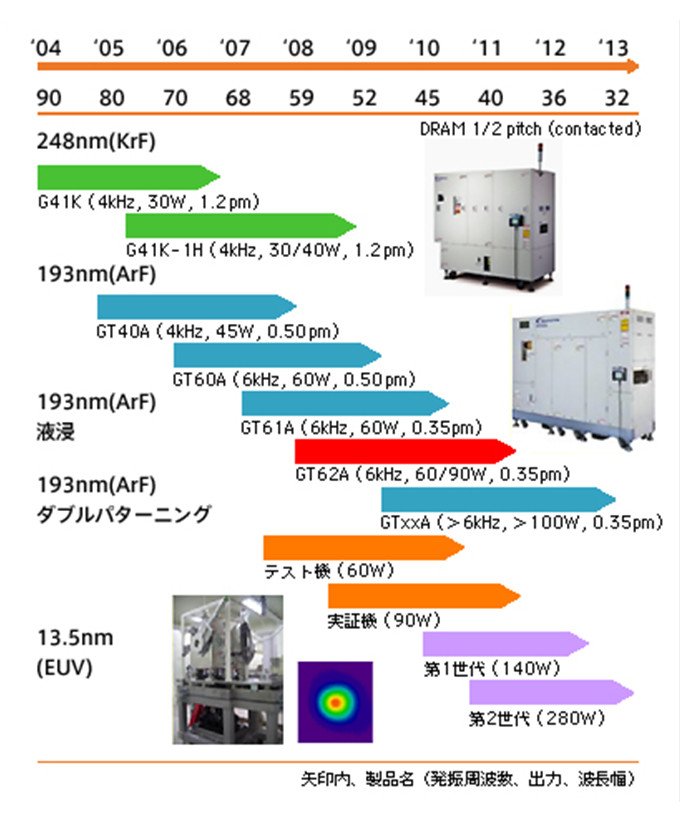
この延長線上にあるのがEUV(13.5nm)であり、従来のArFと比較して波長は1/10以下となり、飛躍的な短波長化が達成されました。
EUV光源は、長く実現が望まれつつも技術的な課題が多く、実用化まで大変な時間を要しました。
そのため、上の図にあるように、既存の193nm(ArF)光源を維持したまま、短波長化以外の方法で微細化を実現しようと
(1)液浸露光によって見かけ上の波長を短くしたり、
(2)ダブルパターニング(パターン工程を2回に分けて実施)を含むマルチパターニング(パターニング工程を2回 以上に分けて実施)により工程数を増やして微細化を追求したり、
(3)光近接効果補正(OPC)などの解像度向上技術(RET)により解像度を向上させたり、
と多様な工夫がなされてきました。
しかし、微細化の限界・工程の複雑化・設計の柔軟性のなさ・重ね合わせ誤差などの課題に直面していたところで、ようやく、短波長を用いてシンプルな露光で微細なパターンを描くEUV露光が実現しました。
※光近接効果補正(OPC)とは、微細化が進むにつれてパターンのコントラストが低下する(角が丸まる、など)ことへの対策。形状誤差を補正するためのシュミレーションをして、補正値を反映させる。例えば角がはっきり現れる回路パターンを投影すると設計通りに転写出来ない場合に、あえてその丸まる分を織り込み済みになるようマスクパターンを補正し、最終的に転写されるパターンが当初の回路パターンになるようにする。
EUV露光装置の構造
EUV露光装置の基本的な構造は、従来のDUV露光装置と共通しており、「模様を描いた原版に光を当て、スクリーンに投影する」という写真やプロジェクタに似た構成です。
両者の主な違いは、2点あります。
第1に、使用する光源が根本的に異なる点、
第2に、EUVという短波長・高エネルギーの光を用いるために、装置全体の設計に特有の工夫が必要となる点です。
EUV光源
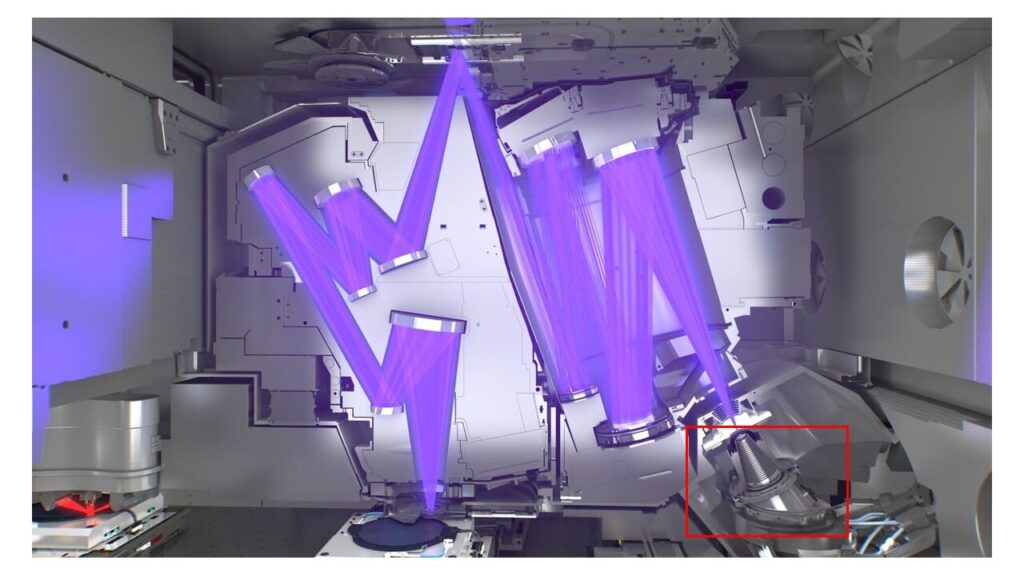
EUV光源の種類と原理
新たな光源となるEUVを効率よく発生させるには、高温高密度プラズマ(プラズマ:電子とイオンが電離した状態)を生成し、そこから放射させる方法が用いられます。
そのプラズマ生成方法としては、次の2種類があります。
(1)LPP(Laser Produced Plasma:レーザー生成プラズマ)
ターゲット物質にレーザーを照射してプラズマを生成し、このプラズマから放射されるEUV光を利用する
(2)DPP(Discharge Produced Plasma:放電生成プラズマ)
放電によってプラズマを生成し、このプラズマから放射されるEUV光を利用する
EUVリソグラフィの量産装置で実際に採用されているのは、このうち(1)LPP方式です。
例えばASMLが買収した米国の光源メーカであるCymerでは、Sn(スズ)を加熱・溶融して、20-30μm程度の液滴にし、高出力レーザー(CO2レーザー)を2度照射(プレパルス・メインパルス)することでプラズを生成、イオンと電子との衝突による電離・励起によってEUV光を放射させます。
EUV光源における課題としては、高出力化の向上が挙げられます。EUV光源の出力が十分に大きくないと、露光に時間がかかり、スループット(生産性)の低下と直結するためです。
コレクターミラー(集光ミラー)
EUV光源で発生したEUV光は、全方位に放射されます。
そのため、これを一方向に集めるために、多層膜反射(Mo/Siなど)で構成され、EUVのみを効率的に反射する「コレクターミラー(集光ミラー)」で反射・集束します。
こうして集光されたEUV光は、IF(Intermediate Focuspoint:中間集光点)でこれ以降の露光に引き渡され、次の反射光学系へと導かれます。
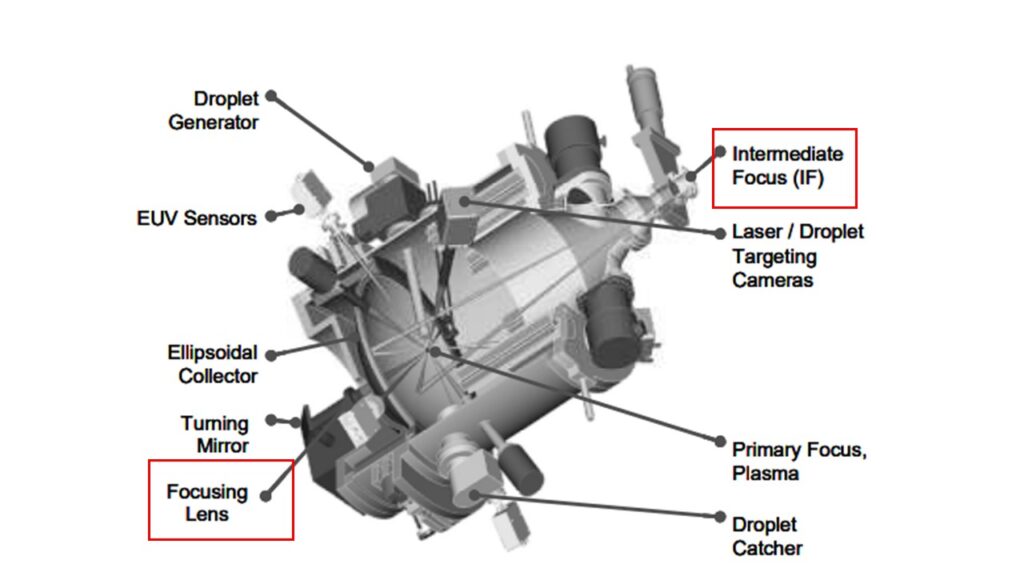
EUV露光装置の設計上の課題
短波長・高エネルギーのEUV光は、あらゆる物質に吸収されてしまうため、装置全体の設計に特有の工夫が必要です。
反射型光学系(多層膜ミラー・保護層・複数ミラーの組合せ)
EUV露光装置では、従来のDUV露光装置のようなレンズ(屈折光学素子)を使うことが出来ません。
これは、EUV光が高エネルギーかつ短波長であるため、石英(SiO2)など従来の材料ではほとんど吸収されてしまい、透過できないためです。
さらに、波長13.5nmという極端に短い波長では、物質の屈折率がほぼ1に近づき、屈折による集光が難しくなります。
このため、EUV光を光学的に制御するには、「反射光学系」が不可欠となります。
この反射光学系では、光の反射・集光を担う、「多層膜ミラー(multilayer mirror)」が使われます。具体的には、モリブデン(Mo)とシリコン(Si)を交互に積層した構造が採用され、層の厚さなどを最適化して、13.5nmのEUV光付近の高い反射率を実現しています。
また、EUV光は高エネルギーのためにミラーの表面が損傷を受けやすく、耐熱性・耐放射線性を持たせるため、表面には保護膜(コーティング)も施されます。複数のミラーを組み合わせて反射を繰り返すことで、レチクルからウエハまで正確にパターンを投影する設計となっています。
マスク(反射型マスク・保護層・吸収体)
DUV露光装置で透明基板(石英ガラス)にクロムなどの遮光材を塗布した透過型マスクが用いられるのと異なり、EUV露光装置では、回路パターンを反射で投影するため、「反射型マスク」を使用します。
反射マスクは、例えば高出力EUV光による熱変形に耐えるために熱膨張の小さなガラス材を用いた基板上に、13.5nmの波長を反射するMo/Si多層膜(反射層)を形成し、さらに酸化防止などの目的で保護層を重ねます。
その上に、吸収体(アブソーバー)で回路パターンが描画され、吸収体のない非吸収領域でEUV光を反射させます。
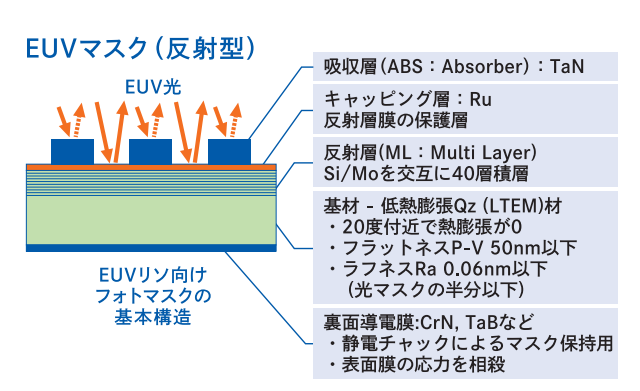
EUVは波長が短く、微細欠陥の影響が大きいため、ブランクス(まだパターンが描かれていないEUVマスクの原版)表面が平坦であることが非常に重要になります。さらにペリクル(マスク表面を覆う防塵膜)の使用が困難なことから、マスク単体での汚染防止やガス環境制御が重要です。
投影光学系(多層膜ミラー・反射角度・アラインメント)
投影光学系は、複数の多層膜ミラー(Mo/Si反射鏡)で構成され、レチクル上の回路のパターンをウエハに塗布されたレジスト層へと縮小投影します。
EUV露光では反射ミラーのみで構成されるため、各ミラーをでどの位置に光を当ててどの方向に反射させるかを制御することが重要です。
さらに投影時にはレチクルとウエハの位置合わせ(アラインメント)のナノメートル精度での同期制御技術が不可欠です。
真空チャンバーとその設計上の工夫
短波長・高エネルギーであるEUV光は、空気中の分子(酸素・窒素など)によって吸収されるため、大気中をほとんど透過できません。
そのため、EUV露光ユニット全体は、真空チャンバー内に設置され、高真空(high vacuum)が維持されます。
ただし、真空環境下では対流や伝導による熱放散が制限されるため、装置内部の熱の制御が課題になります。
特に、高出力EUVやミラー周辺のこの真空環境は、EUVが吸収されることによるEUV光の損失を防ぎ、ウエハに到達する光の量を維持します。また、外部環境からの遮蔽により、光学系の汚染を抑制する面もあります。
まとめ
13.5nmという極端に短い波長の光を使って、微細な回路パターンをウエハに転写する最先端のEUV露光装置をまとめました。背景知識として、次に進みます。
参考:
ASML「Light and lasers」https://www.asml.com/en/technology/lithography-principles/light-and-lasers
CYMER 「How An EUV Light Source Works」https://www.youtube.com/watch?v=5yTARacBxHI
ウシオ電機「EUV光源の開発状況」https://www.ushio.co.jp/jp/technology/lightedge/201103/100414.html
理化学研究所「多価イオンの新分光法を実証-多電子重元素多価イオンの超微細構造を観測-」https://www.riken.jp/press/2023/20230124_1/index.html
東京エレクトロン「半導体の微細化に不可欠なEUV露光技術の現状とこれから」https://www.tel.co.jp/museum/magazine/report/202310_01/
一般財団法人表面技術協J-stage「真空紫外光による高分子材料の大気圧表面改質」https://www.jstage.jst.go.jp/article/sfj/63/12/63_751/_pdf
堀場「極端紫外線リソグラフィー技術の現状および課題、並びに今後の展望」https://static.horiba.com/fileadmin/Horiba/Company/About_HORIBA/Readout/JA/R51J/R51J_13_050.pdf
小松「半導体製造用短波長光源:エキシマレーザーからLPP‐EUV光源への挑戦」
https://www.komatsu.jp/jp/company/tech-innovation/report/pdf/170331_06.pdf
ギガフォトン「極端紫外光用ミラーおよび極端紫外光源装置」 JP5061063B2
https://patents.google.com/patent/JP5061063B2/ja


コメント