前回の記事では、EUV露光装置の概要をまとめましたが、その際、内部で生じる炭素汚染の問題にも触れました。
特に光学素子などの高精度部材に対する汚染は、リソグラフィ工程の性能や歩留まりに直結する深刻な課題です。
今回は、そうした炭素汚染のなかでも、特に除去困難なC-C単結合を含む有機物に注目した、やや古い特許(WO 2009/133759 A1)を取り上げます。
想定される炭素汚染源
EUV露光装置で実際に問題となる炭素汚染源は、以下のような汚染物が想定されています。
(1)真空ポンプオイル由来
短波長・高エネルギーのEUV露光装置は、真空雰囲気が必須となりますが、この環境を整える真空ポンプのオイルや潤滑剤やシール材から発生するアウトガス。
(2)レジスト由来
EUV照射によりレジストの樹脂成分が熱分解したり、炭化する過程で発生する揮発成分。
(3)プラズマ発生源由来
プラズマ発生源(スズSnなど)の飛散や副生成物に伴うアウトガス。
これらの炭素系物質は、装置内の光学素子表面に堆積し、反射率やパターン形成の精度に悪影響を与える要因となります。
C-C単結合に着目する理由
汚染物には、C=C(二重結合)やC≡C(三重結合)などの不飽和炭化水素も含まれますが、これらはπ結合を有するため比較的反応性が高く、酸化やプラズマなどの従来方法で比較的容易に分解可能です。
従来の除去法とその限界
酸化法
酸素(O₂)やオゾン(O₃)などの酸化剤を使って、炭素汚染物を二酸化炭素(CO₂)と水(H₂O)にまで分解します。
$$ \mathrm{C}_x\mathrm{H}_y + O_2 \rightarrow CO_2 + H_2O $$
ここでの汚染物(CxHy)は、炭素と水素からなる汚染有機物です。
ただし、この方法は反応性の高い不飽和結合には有効ですが、C-C単結合の分解には十分ではありません。
酸素プラズマ法
酸素をプラズマ化して得られる活性酸素種(酸素ラジカルなど)を利用し、有機物を酸化分解する方法です。従来のEUV露光装置でも採用されていましたが、こちらも不飽和結合に比べてC–C結合への作用は限定的であり、除去効率には限界がありました。
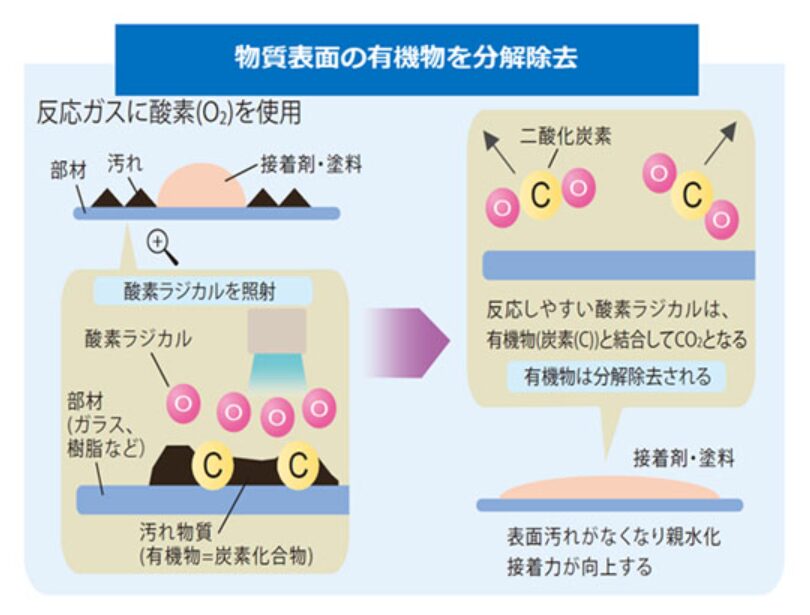
提案技術:水素ラジカル法による除去
飽和炭化水素のC-C結合を効果的に分解するため、水素ラジカルを用いた還元的な手法が検討されました。
水素ラジカルとは
ラジカル(radical)とは、不対電子を持つ高反応性の化学種です。水素ラジカル(H・)は、水素分子(H₂)のH-H結合を均等に切断(ホモリティック開裂)して生成されます。
$$ \mathrm{H_2} \rightarrow 2 \cdot \mathrm{H{\cdot}} $$
しかし、このH–H結合の解離には、約 436 kJ/molの高いエネルギーが必要(東京工業大学資料より)であり、自然状態でラジカルに解離することは困難です。

そのため、何らかの補助的な手段でラジカルを効率的に生成する必要があります。
本明細書では、金属触媒を用いて水素分子の結合を活性化し、ラジカルを低温で効率的に生成する手法が提案されています。(※触媒の詳細原理については、次の記事で記載します。)
従来技術との比較
従来の露光装置では、酸素プラズマ法などの酸化的手法が用いられてきました。酸素プラズマ法では、原子状態酸素(O)やオゾン(O₃)、酸素イオン(O₂⁺)などに加えて、酸素ラジカル(O・)も生成され、これらが有機汚染物に対して酸化反応を引き起こします。
ラジカルであれば反応性は高いのですが、酸素ラジカルは電子を奪う「酸化的反応」を誘起します。一方、水素ラジカルは電子を与える「還元的反応」を起こす点で性質が異なります。この違いが、飽和炭化水素のC-C単結合に対する反応性に影響します。
C=CやC≡Cなどの不飽和結合は、π電子の非局在化により求電子作用を受けやすいのに対し、C–C単結合は電子の偏りが少なく、この作用が起こりにくいためです。
そこで、C–C単結合を含む汚染物の除去には、酸化的手法よりも還元的手法の方が適しており、水素ラジカルがより効果的に作用すると考えられます。
特許の工夫点
金属触媒モリブデンMo
提案技術では、金属触媒としてモリブデン(Mo)またはその合金を採用しています。
Moは、原子番号42の金属元素で、比較的高い融点(2,623℃)を有し、熱安定性に優れており、比重が軽いことを特徴としています。
従来使用されていた、タングステン(W)(融点:3,422℃)よりは融点がやや低いものの、加工性に優れており、比較的低温でも従来と同等のラジカル生成効率を実現できる点が評価されています。
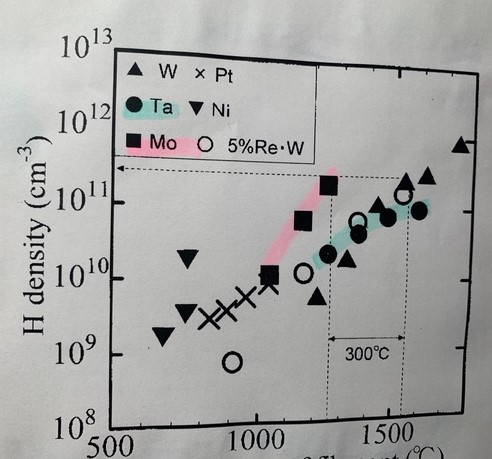
これによって、従来よりも光学素子への熱ダメージを抑えつつ、水素ラジカルの供給が可能になることが期待されました。
なお、明細書ではラジカルでどのようにクリーニングするか、については制限は設けておらず、このラジカル発生自体に着目しています。
構造的工夫:シャッター構造(ラジカル発生装置)
さらに、本明細書では、ラジカル発生装置に細孔付きのシャッター構造を設けるという構造的な工夫もされています。この構造の目的は、以下の通りです。
1)高温のMo線からの放射熱(伝導、対流、以外の熱の伝わり方で、温度差に基づく熱伝導。真空中でも伝わる)が直接光学素子や基板に直接伝わらないように遮蔽
2)蒸気化したMoが基板に再付着しないよう、物理的に隔離
3)シャッターの細孔を通して、水素ラジカルが均一に拡散・供給されるように制御
このような構成によって、装置内部への熱負担や金属汚染は抑制し、ラジカルを有効に活用することが可能になります。
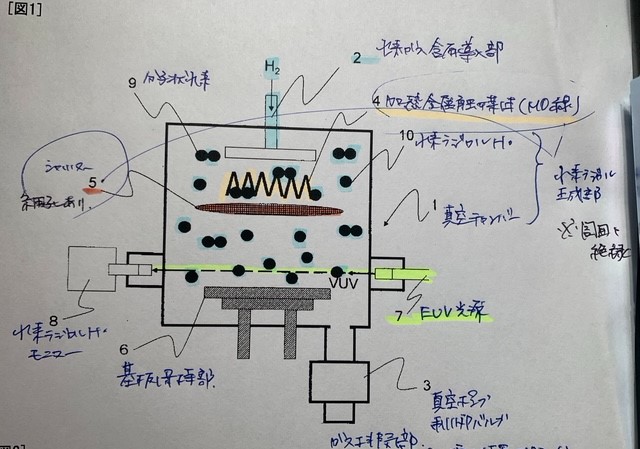
まとめ
この特許は、水素ラジカルを用いたEUV露光装置のクリーニング技術の一つとして、モリブデン(Mo)触媒による低温ラジカル生成と、放射熱などの対策をしたシャッター設置という構造的工夫を組み合わせています。
しかし、国際調査報告では、水素ラジカルの利用や金属触媒によるラジカル生成はすでに知られており、Moを採用すること自体は「特別な技術的特徴(special technical feature)」を欠くとして新規性が否定されています。一方で細孔付きシャッター構造などの熱遮蔽工夫については、引用文献に明確には記載が確認できませんでしたが、進歩性ありと評価されたかについては不明です。
EUV技術の初期には、汚染の分解対象ごとの対応に加え、より高精度な光学素子を保護しつつ、スループット低減の大敵である汚染をいかに除去するかという観点から、触媒や構造的工夫など多方面から技術的な検討がなされていたことが分かります。
参考:
名城大学 有機化学Ⅰ「ラジカル反応」
https://www1.meijo-u.ac.jp/~tnagata/education/ochem1/2021/ochem1_14.pdf
日本金属学会 まてりあ第60巻第5号(2021)
https://jimm.jp/around_metal/ranking/16.molybdenum.pdf
タングステン・モリブデン工業会「タングステン・モリブデンの特⻑」
https://jtmia.com/w-mo
筑波大学 「輻射伝熱」
https://www.kz.tsukuba.ac.jp/~abe/ohp-energy/en2017-02.pdf
「多層膜反射鏡、euv露光装置、及び多層膜反射鏡におけるコンタミネーションの除去方法」JP2006194690Aニコン
https://patents.google.com/patent/JP2006194690A/ja



コメント